
Nach dem Wafer-Polieren finden wir häufig eine große Anzahl von Restpartikeln auf der Oberfläche. Diese Partikel stammen normalerweise aus zwei Quellen:
Erstens enthält die Poliersuspension eine große Menge an Abrasivpartikeln. Obwohl diese Abrasivpartikeln extrem klein sind, besitzen sie einen gewissen Grad an Haftfähigkeit und haften nach dem Polieren direkt auf der Wafer-Oberfläche.
Zweitens entsteht während des Polierprozesses Reibung zwischen Poliermedium und Produkt, die eine Schneidkraft erzeugt. Die festen Partikel des Produkts, die von der Produktoberfläche abgetragen werden, werden in die Wafer-Oberfläche eingebettet.
Da die beiden oben genannten Fälle eine Kontamination der Wafer-Oberfläche verursachen und zu Defekten wie Kratzern führen können, verwenden wir nach dem chemisch-mechanischen Polieren (CMP) üblicherweise einen Bürstenreiniger zur Reinigung der Wafer-Oberfläche.
Der Bürstenreiniger besteht aus PVA (Polyvinylalkohol)-Material, das weich ist und die Wafer-Oberfläche nicht kratzt, sondern gleichzeitig verschiedene Partikel auf ihr effektiv reinigt. Darüber hinaus empfehlen wir, den Polierpad regelmäßig zu ersetzen, um die Wafer-Kontamination zu reduzieren.
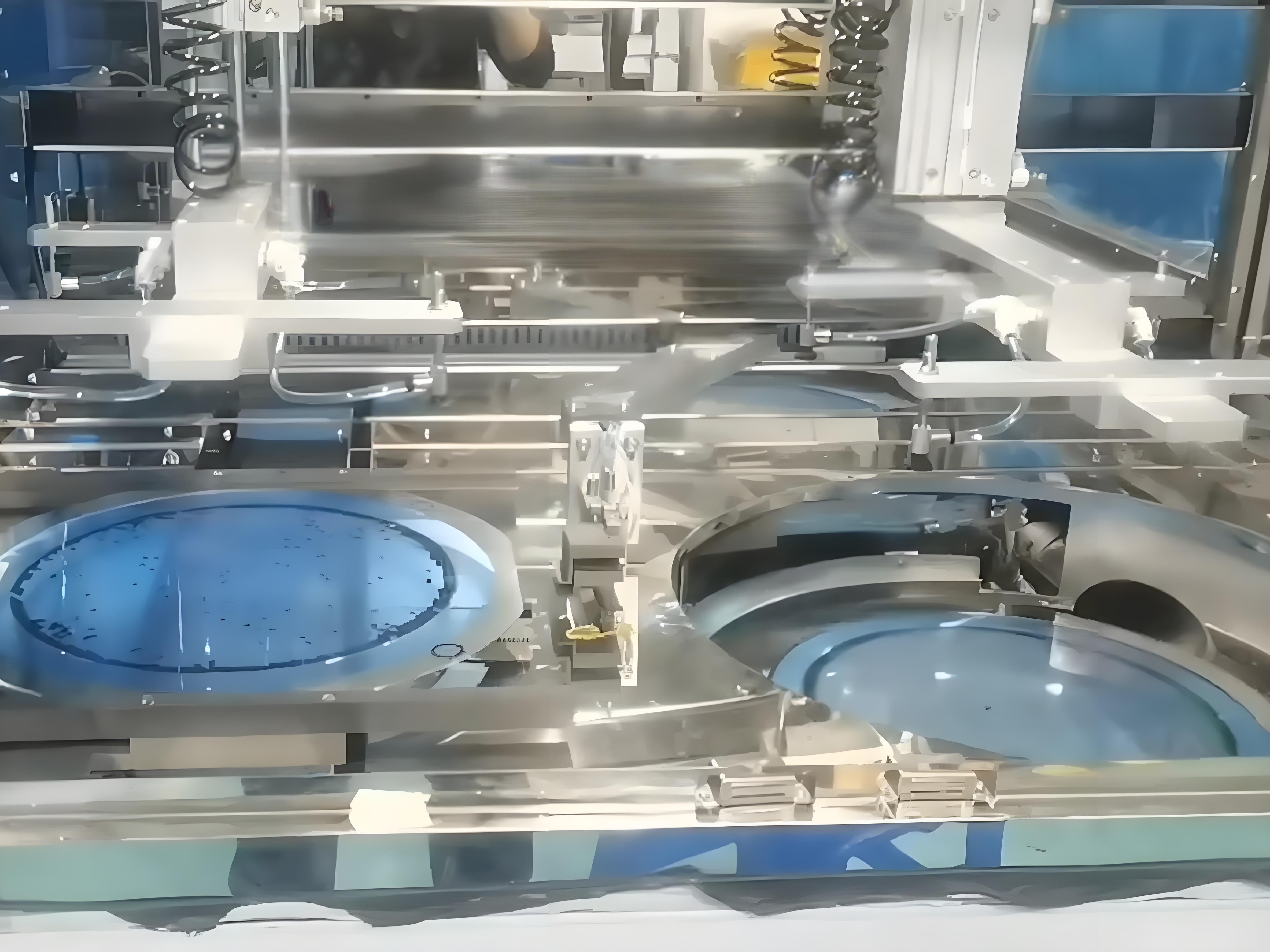











WeChat scannen